ウエハダイシング
ダイシング工程はウエハを個々のチップに分離する工程です。
SiウエハはもとよりGaAs等の化合物半導体ウエハのダイシングを行っております。
Disco DFD-6340 DFD-641 DFD-651
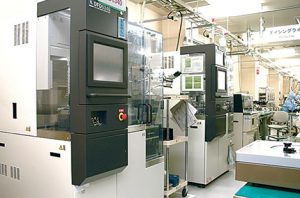
当社の工程についてご紹介いたします。
各工程の詳細な説明および保有設備に関しては、以下でご確認いただけます。
また、一覧については下記からダウンロードが可能ですので、事前にエントリーの上、ダウンロードをお願いいたします。

ダイシング工程はウエハを個々のチップに分離する工程です。
SiウエハはもとよりGaAs等の化合物半導体ウエハのダイシングを行っております。
Disco DFD-6340 DFD-641 DFD-651
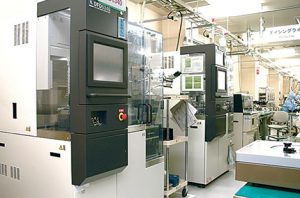
ダイボンド工程は、お客様より提供頂いたチップをサブストレート上に接着、固定する工程です。
サブストレートは、セラミック基板、PCB基板、リードフレーム等に対応でき、チップ接合材は、Agペーストや共晶半田、金属焼結剤などの実装に対応しております。
Canon BESTEM-D01 / BESTEM-D10Sp
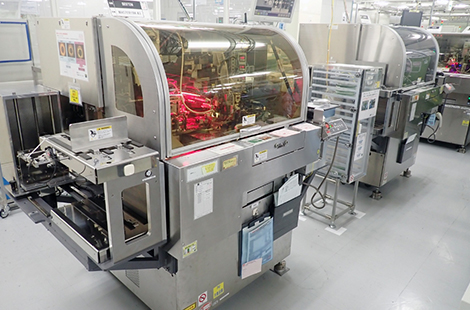
フリップチップ工程では、チップのパッドと基板を電気的に接合する際に、チップを反転させチップ上のバンプを直接基板に接合しています。
これにより従来のチップと基板間をワイヤ接合する方式に比べて小型化・集積化を実現できます。
YAMAHA i-CubeⅡ
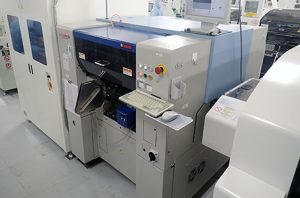
ワイヤボンド工程では、Au線、Cu線及びAI線を使って、チップなどと電極間を配線しています。
お客様のご要求に応じた最適なワイヤリング品質を、材料・治工具・条件等を最適化し、実現しております。
新川 UTC-3000/2000/1080
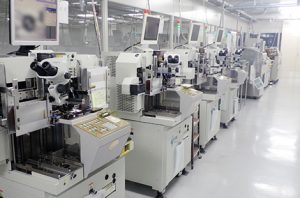
アンダーフィル工程は、フリップチップ工程にて直接基板を接合したチップの接合部を補強する工程です。これにより、振動が多い場所や環境温度の変化が極端な場所でも継続した安定動作を保証しています。
武蔵エンジニアリング TAD1000/FAD320S
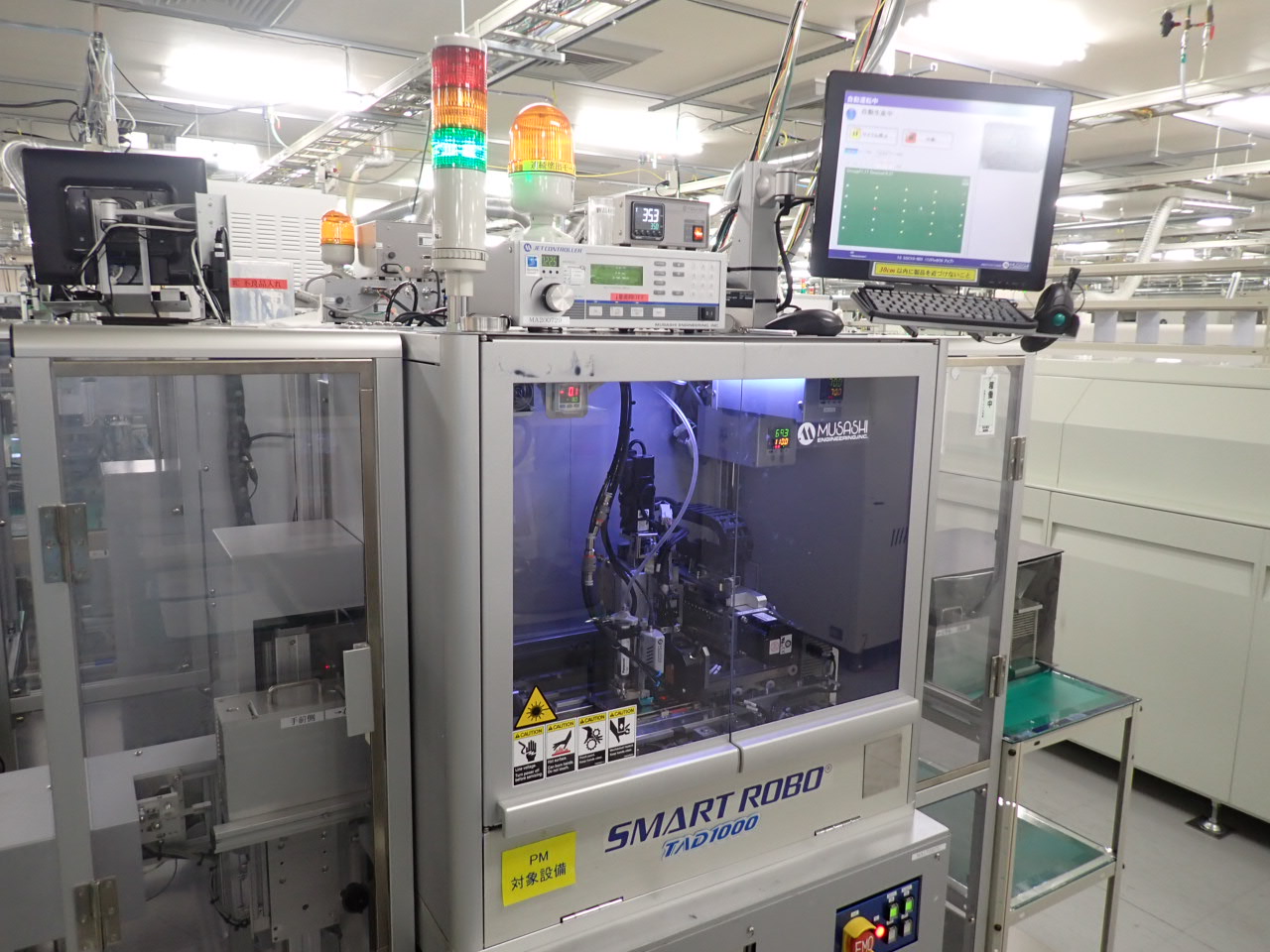
部品実装工程では、最小で0402部品からBGA及びコネクタを実装し、ベアチップも混載が可能です。
対象とする基板はセラミック、樹脂基板及びFPCの実績があります。
PFSC CM-602/402、YAMAHA YSM10
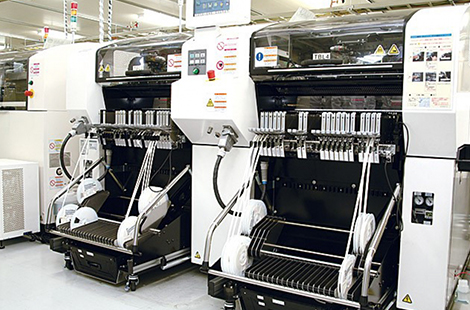
封止工程は、基板上に配置されたチップや回路を樹脂や金属で封じ込めるプロセスです。この工程により、機械的な衝撃や湿気、温度変化などの外部環境から保護され、製品の信頼性が向上します。特に、部品の小型化が進む中で、狭いスペースに樹脂をしっかりと流し込む技術が重要視されています。当社では、このようなニーズに応えるために、真空技術を駆使したさまざまな装置を取り揃え、精密な封止を実現しています。
I-PEX GP-PROsf120/東レ VE500C/武蔵 TAD1000
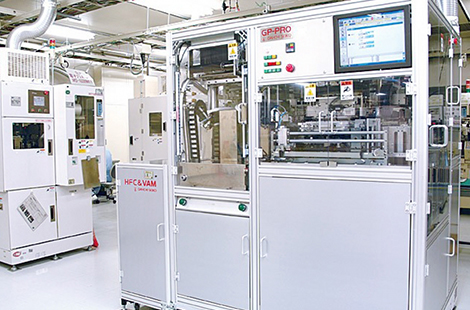
パッケージ分離工程は、各種基板を個片化する工程です。
LTCC及びHTCCセラミックや樹脂基板及びリードフレームなど各種の材質を問わず個片化するプロセスを保有しており、特に当社はダイシング方式による個片化技術に特化した形で、お客様のご要求にお答えしております。
Disco DFD-6341 /6340

テスト工程は、お客様が要求される項目を検査する工程です。
テストボードの設計・調達から、計測機の選定、制御プログラムの制作を行い、テストシステムの構築を一貫で対応しております。
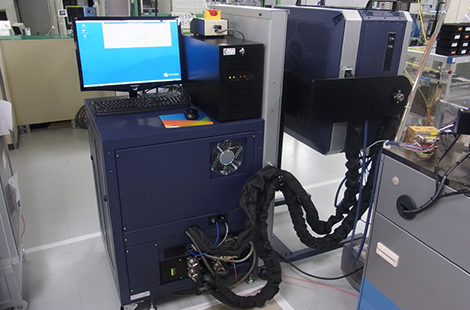
マーキング工程は、各種素材を問わず、YAG方式やCO2方式でのレーザー光もしくはインクで印字を行うものです。
あらゆるフォントに対応したマーキングが可能です。

出荷・梱包工程では、お客様のご要求に応じ、テーピング・トレイ及びチューブへ製品を収納し、内装、外装段ボールへの収納や段ボールへのカスタム表示等、エンドユーザー様へ直接納入できる形態などにも対応致します。
藤堂製作所 TT-1500 / TT-900

PAGE TOP