フリップチップ
フリップチップ工程とは、集積回路を180度反転(フリップ)させてから回路基板へ実装する際、アレイ(格子)状に並んだバンプと呼ばれる突起状の電極端子によって密着させ、電気的に接続する工程です。
ワイヤボンディング工程では、集積回路と基板を金属線を用いて電気的に接続しているため、電極を上面として配線していますが、フリップチップでは、電極が下面となるように反転して回路基板へダイレクトに実装することから、フリップチップと呼ばれています。
ワイヤボンディングに比べて短配線になるのが特徴で、小型,薄型に対する要求の強い機器の回路や、電気的特性が重視される回路などに向いています。
また、集積回路を反転して実装するため、パッケージ上面に電極が無く電極を保護する樹脂封止が不要になります。
製品仕様に最適な治工具の設計から作製まで、当社にて対応可能で、試作開発や少量対応、短納期など、お客様のニーズに合わせたフリップチップボンディングサービスをご提供いたします。
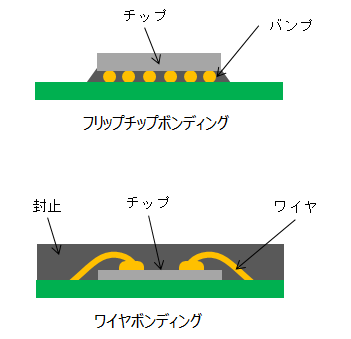
フリップチップ実装の評価
ボンディングテスターを用いた集積回路と基板の接合強度試験やX線透過装置を用いたバンプの位置ずれ確認、断面研磨による接合部の断面観察等、各種評価に対応致します。
シェアテスト シェア強度測定
荷重センサに取り付けられたツールが基板面まで下降し、装置が基板面を検出し下降を停止します。検出した基板面より設定された高さまでツールが上昇し、ツールで接合部を押し破壊時の荷重を測定します。
X線透過検査 バンプの位置ずれ確認
X線透過装置によるバンプの位置ずれ確認を対応致します。
断面研磨 接合状態確認
研磨装置を用いて集積回路と基板の接合部の断面を削り出し、観察・撮影・測定を対応致します。
合金層(金属間化合物)の状態確認やバンプのクラックやボイドなどの接合不良の有無確認を行っています。
物理的に試料の断面を出す為、非破壊検査では発見する事が困難な微細な異常の観察や、X線で透過できない部品の内部を観察する事が可能です。
フリップチップの装置ラインナップ
- i-Cubeシリーズ(ヤマハ発動機㈱) C4接続
お客様のお悩みをSMEが解決します。
秘匿性の高い製品や高価な材料を扱うことを得意とし、様々な形でお客様のご要求にお応えしております。
累計4,000件を超える試作実績から得たノウハウでお客様のお悩みをズバッと解決いたします。
少量生産の対応も可能であり、一個からでもご注文をお受けしております。
お悩み事がございましたらお気兼ねなくご相談ください。
4000件を超える試作実績で得たノウハウで、お客様を全面サポート
-
 自動と手組、どちらも対応可能
自動と手組、どちらも対応可能
-
 半導体のことなら何でもお任せ
半導体のことなら何でもお任せ
-
 製品開発からお客様と共に対応
製品開発からお客様と共に対応
-
 お客様の要望(仕様)に
お客様の要望(仕様)に
オーダーメイドにて対応 -
 製品開発から量産、
製品開発から量産、
材料調達までワンストップで対応 -
 カスタム品を汎用品のように扱える
カスタム品を汎用品のように扱える

