アンダーフィル
アンダーフィル工程とは、フリップチップ工程にて基板に実装された集積回路(半導体チップ)が電極端子から外れないように基板と集積回路の間へ液状のエポキシ樹脂(アンダーフィル材)を毛細管現象により浸透させ、接合部の補強をする工程です。
アンダーフィルは、外部からの応力を軽減でき、基板と集積回路の接合部に生じる応力の集中を防止する働きがあります。
また、基板と集積回路の熱膨張係数の違いにより発生する接合部のストレスを分散させ、製品の信頼性を高める効果を持っています。
SMEは製品仕様に最適なアンダーフィル材を選定し、高品質は勿論、作業効率を考慮したアンダーフィル技術サービスをご提供いたします。
試作開発や少量対応、短納期などにも対応致しますので、お気軽にお問い合わせください。
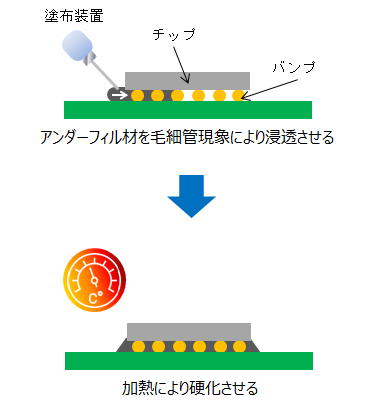
アンダーフィルの技術
SMEのアンダーフィル技術は集積回路と基板のギャップが45μm以下でも充填が可能です。
また、集積回路の表面にアンダーフィルを這い上がらせないよう、微細な塗布コントロールが可能です。
抵抗器、コンデンサなどの受動部品の半田接合部に対してアンダーフィルを行うなど、部分的な対応も可能です。
アンダーフィルの評価
断面研磨によるボイドの観察等、各種評価に対応致します。
協力会社にて非破壊検査である超音波深傷検査(SAT)も対応致します。
断面研磨 ボイド確認
研磨装置を用いて集積回路と基板の接合部の断面を削り出し、観察・撮影・測定を対応致します。
アンダーフィルのボイドなどの接合不良の有無確認を行っています。
物理的に試料の断面を出す為、非破壊検査では発見する事が困難な微細な異常の観察や、X線で透過できない部品の内部を観察する事が可能です。
アンダーフィルの装置ラインナップ
- TAD1000(武蔵エンジニアリング㈱) ジェットディスペンサタイプ
- FAD320S(武蔵エンジニアリング㈱) エアーディスペンサタイプ
お客様のお悩みをSMEが解決します。
秘匿性の高い製品や高価な材料を扱うことを得意とし、様々な形でお客様のご要求にお応えしております。
累計4,000件を超える試作実績から得たノウハウでお客様のお悩みをズバッと解決いたします。
少量生産の対応も可能であり、一個からでもご注文をお受けしております。
お悩み事がございましたらお気兼ねなくご相談ください。
4000件を超える試作実績で得たノウハウで、お客様を全面サポート
-
 自動と手組、どちらも対応可能
自動と手組、どちらも対応可能
-
 半導体のことなら何でもお任せ
半導体のことなら何でもお任せ
-
 製品開発からお客様と共に対応
製品開発からお客様と共に対応
-
 お客様の要望(仕様)に
お客様の要望(仕様)に
オーダーメイドにて対応 -
 製品開発から量産、
製品開発から量産、
材料調達までワンストップで対応 -
 カスタム品を汎用品のように扱える
カスタム品を汎用品のように扱える

