Wafer Dicing
The dicing process is the step where wafers are separated into individual chips.
We perform dicing not only for silicon (Si) wafers but also for compound semiconductor wafers such as GaAs.
Disco DFD-6340 DFD-641 DFD-651
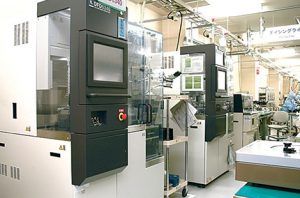
We would like to introduce our processes. Detailed descriptions of each process and the equipment we possess can be viewed below.
Additionally, a downloadable list is available, so please register in advance and download it.

The dicing process is the step where wafers are separated into individual chips.
We perform dicing not only for silicon (Si) wafers but also for compound semiconductor wafers such as GaAs.
Disco DFD-6340 DFD-641 DFD-651
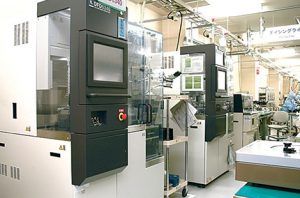
The die bonding process involves attaching and securing the chips provided by customers onto substrates.
Our substrates accommodate various types, including ceramic substrates, PCB substrates, and lead frames. For chip bonding materials, we support implementations using Ag paste, eutectic solder, and metal sintering agents.
Canon BESTEM-D01 / BESTEM-D10Sp
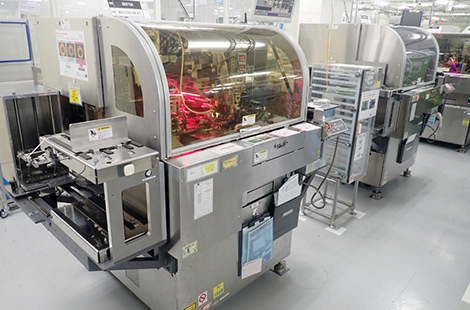
The flip-chip process, the chip is flipped so that the circuit side faces the substrate, and the bumps on the chip are directly bonded to the substrate, establishing an electrical connection. This method enables greater miniaturization of products and higher-density component placement compared to conventional wire bonding methods for connecting chips to substrates.
YAMAHA i-CubeⅡ
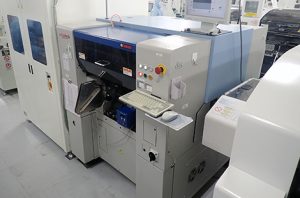
The wire bonding process, gold (Au), copper (Cu), and aluminum (Al) wires are used to precisely connect the chip to the electrodes on the substrate.
By optimizing the selection of materials, tools, and process conditions according to customer requirements, we achieve high-quality and reliable wire bonding.
新川 UTC-3000/2000/1080
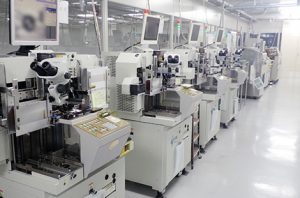
The underfill process is a step that reinforces the bond between the chip and the substrate after the flip-chip process. This ensures that the chip continues to operate stably, even in environments with high vibration or significant temperature fluctuations.
武蔵エンジニアリング TAD1000/FAD320S
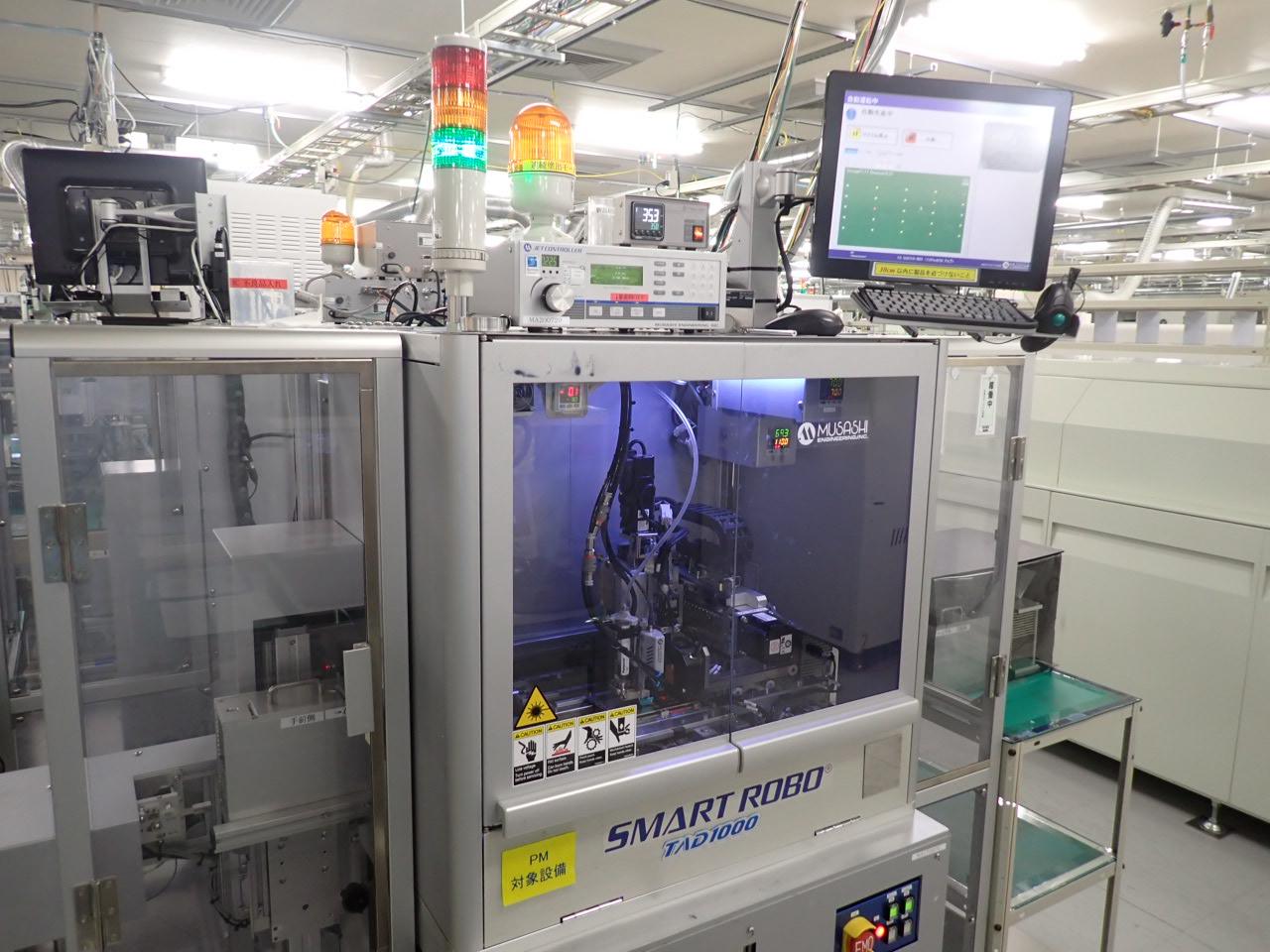
The Surface Mount Technology Process, we mount components as small as 0402, as well as BGA and connectors, and we can also handle mixed mounting with bare chips.
The substrates we work with include ceramic, resin boards, and FPCs (Flexible Printed Circuits), with proven results.
PFSC CM-602/402、YAMAHA YSM10
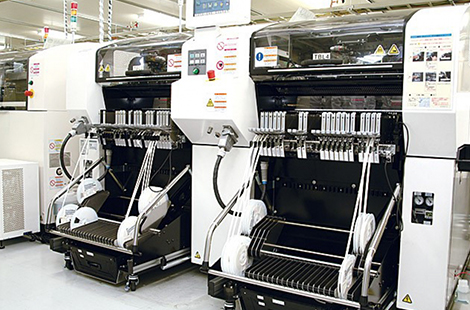
The encapsulation process involves sealing chips and circuits on substrates with resin or metal to protect them from mechanical shocks, moisture, temperature changes, and other environmental factors, thereby enhancing the product's reliability. As components continue to miniaturize, the ability to inject resin into narrow spaces has become increasingly important. To meet these demands, we utilize various devices that employ vacuum technology.
I-PEX GP-PROsf120/東レ VE500C/武蔵 TAD1000
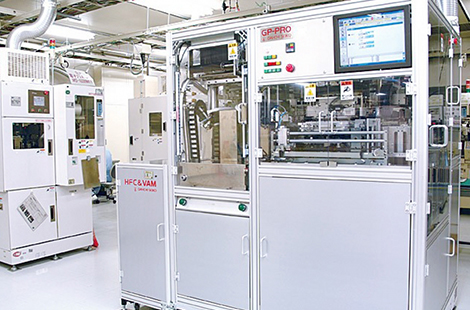
The package separation process involves cutting various types of substrates into individual components.
We offer separation processes that accommodate a wide range of materials, including LTCC and HTCC ceramics, resin substrates, and lead frames. In particular, we specialize in using the dicing method for separation, providing services tailored to meet our customers' specific requirements.
Disco DFD-6341 /6340

The electrical characteristics inspection process is where the electrical performance and characteristics of a product are tested according to the customer's requirements.
In this process, we handle everything from the design and procurement of the test board (a special test substrate) to the selection of the necessary measurement equipment, and the creation of the control programs for operating these devices, providing a comprehensive testing system.
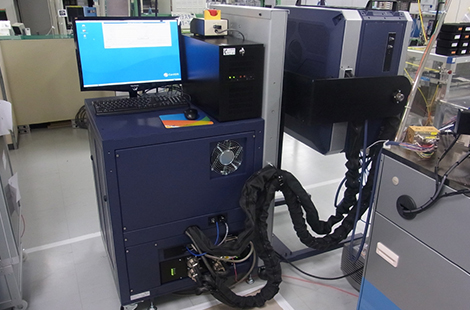
The marking process involves printing on various materials using YAG laser, CO2 laser, or ink. In this process, high-precision printing of text, logos, numbers, and various designs is possible, and it can accommodate any font for marking.
I-PEX GP-PROsf120/東レ VE500C/武蔵 TAD1000

In the packaging and shipping process, we store products in tapes, trays, or tubes according to customer requirements. We then pack them into inner and outer cardboard boxes and can customize the box labels. We also accommodate delivery in formats that are ready for direct shipment to end users.
TT-1500 / TT-900

PAGE TOP