事例 01
プリント基板・セラミック基板への部品実装・ワイヤボンディングの上での封止を行った複合モジュールの組立が可能です。
1個からの少量の生産も対応致します。
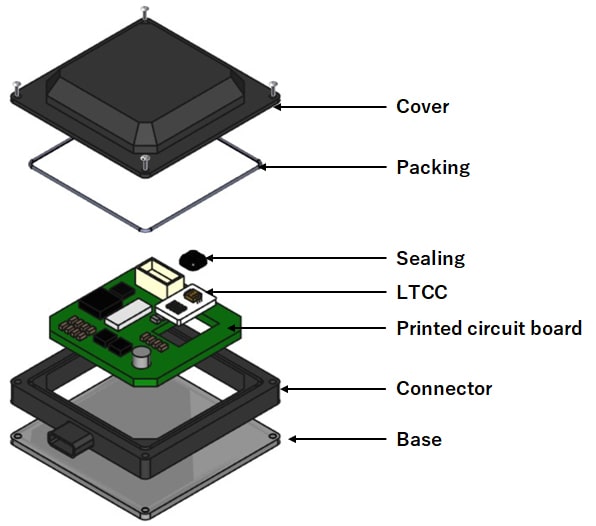
お客様のご要望を満足するため、以下の製造プロセス・手法を活用してお客様の想いを形にさせていただいております。
プリント基板・セラミック基板への部品実装・ワイヤボンディングの上での封止を行った複合モジュールの組立が可能です。
1個からの少量の生産も対応致します。
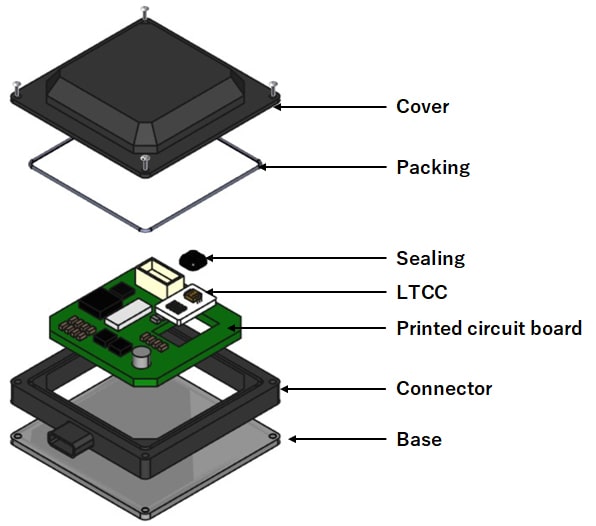
融点の異なるはんだを組み合わせることで、再溶融させない実装が可能です。
プリント基板(PCB)へのリードフレーム実装後、ICや各種部品を順次実装する際も、先に形成したはんだ接合部を溶かすことなく、確実なフィレット形成を実現します。
また、製品の仕様に応じた最適な材料の選定にも対応いたします。
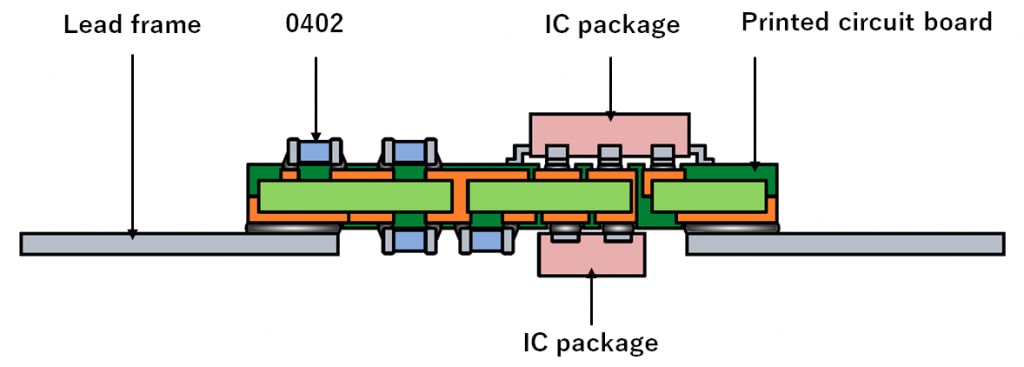
難易度の高い箇所へのアンダーフィルにも対応可能です。
各種サブストレートにチップを実装後、極小の挿入口や限られたスペース内での精密な作業が求められる製品に対し、ジェットディスペンスを用いた高精度なアンダーフィルを実施しています。
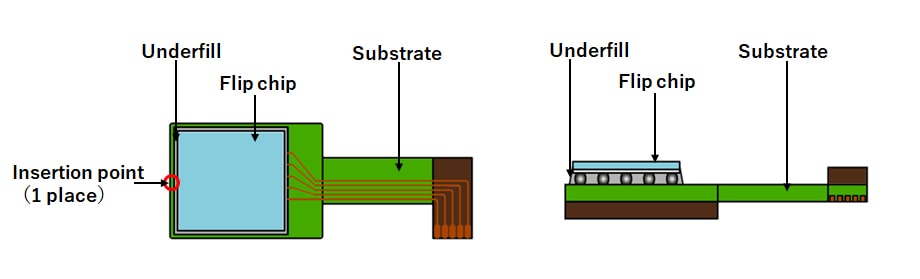
特殊な形状や部分的な封止にも対応可能です。
プリント基板にMEMSセンサーを実装した後、ダム枠を形成し、精密な封止を施すことで、高品質な仕上がりを実現しています。
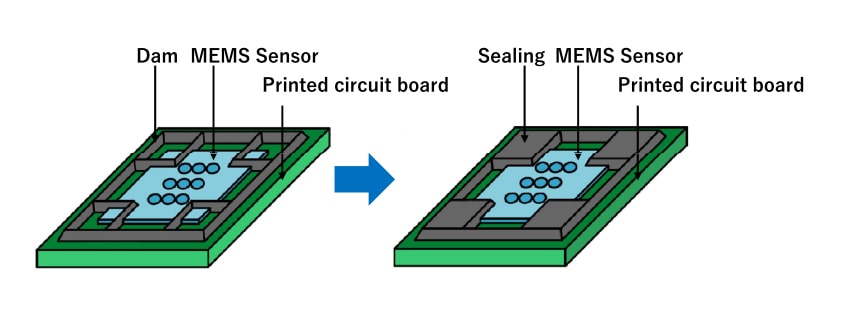
プリント基板(PCB)の両面にダイボンド・ワイヤボンド・部品実装が可能です。
また、社内で治工具の設計を行い、最適なプロセスを構築することで、高品質な製品を提供いたします。
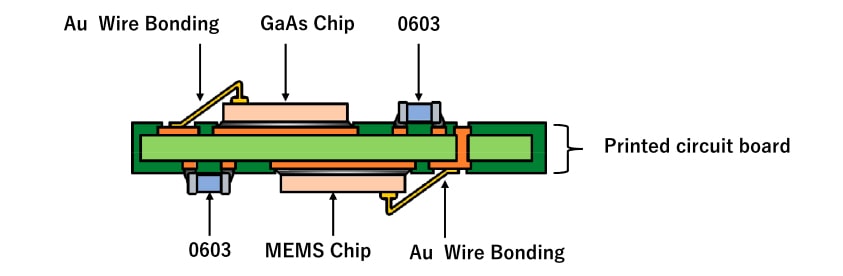
PAGE TOP